- 技術應用 -
26.May.2025
3D X-ray 3D X-ray CT 掌握半導體製程品質的關鍵利器

3D X-ray CT:掌握半導體製程品質的關鍵利器
面對愈趨精細且複雜的半導體封裝結構,傳統2D X-ray已難以應付內部瑕疵的判讀需求。從2.5D、3D封裝到TSV穿孔結構,每一項創新都對品質檢測提出更高挑戰。傳統2D X-ray已難以應付內部結構的瑕疵判讀,此時,3D X-ray CT 成為企業追求高良率與高可靠度的重要解方。
為什麼選擇3D CT?
相較於傳統2D X-ray,3D CT 能夠提供更深入的觀測與解析能力,具體優勢包括:
在封裝與組裝過程中,常見的孔洞(Void)、錯位(Misalignment)、焊點裂縫(Cracks)、TSV斷裂等缺陷,往往難以透過表面觀察或單一角度X-ray影像辨識。
- 重建封裝內部三維結構
- 清楚辨識不同深度層的微小缺陷
- 提供製程參數優化依據
- 減少因判讀錯誤造成的良率損失
真實應用場景
| 製程階段 | CT 應用項目 |
|---|---|
| 晶圓凸塊(Bumping) | Bump 結構分析、高度差偵測 |
| Die Attach / Underfill(晶粒貼合 / 底部填充) | 濕潤性不良、Underfill 氣泡偵測 |
| 打線封裝 | 焊點內部裂縫與脫落分析 |
| 多層封裝(3D IC) | TSV 垂直通孔穿透品質分析 |
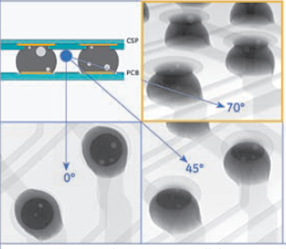
▲圖一 2DX-ray多角度檢測
 ▲圖二 BGA焊點3D CT重建與孔洞圖
▲圖二 BGA焊點3D CT重建與孔洞圖 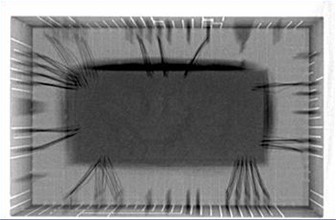 ▲圖三 2DX-ray檢測:封裝內部結構可視化
▲圖三 2DX-ray檢測:封裝內部結構可視化  ▲圖四 3D CT:半導體封裝結構立體重建
▲圖四 3D CT:半導體封裝結構立體重建  ▲圖五 封裝打線2D X-ray檢測 – 判斷接合品質
▲圖五 封裝打線2D X-ray檢測 – 判斷接合品質  ▲圖六 打線封裝的3D X-ray CT切片圖
▲圖六 打線封裝的3D X-ray CT切片圖若有任何技術問題或產品需求,歡迎與我們聯絡!
☎️ +886-2-8990-1779
其他相關訊息
-
28.Jul.2025
X-ray螢光-XRF 錸金假黃金風險防範 | Vanta GX 驗金儀助攻快速精準辨識
-
14.Jul.2025
質譜儀-Mass AI人工智慧如何解密高分子裂解產物結構









