- 技術原理 -
19.Feb.2020
膜厚儀 利用FT150h測量陶瓷晶片部件中Sn/Ni 雙層膜

作為層壓陶瓷片式原器件電容器的代表,陶瓷片式原器件在智慧手機及車載電腦等的無中心部件的一種。近幾年,由於產品的小型化多功能化,我們一步步進入高密度安裝時代,部件本身就已經非常小。

這樣的陶瓷片式原器件的電極部分許多都被使用了Sn和Ni雙層膜,我們追求的就是對他們的膜厚管理。但是,由於Sn越厚,Sn對於Ni受到的螢光X射線吸收越強。Sn和 Ni的同時測量就比較困難。
FT150h配備了新型聚光光學系以及升級後的Vortex®檢測器,對於從前機種難以測量的微小範圍,實現了同時高精度測量更厚的Sn與它下面的Ni,此份資料中介紹了針對陶瓷片式原器件的疑似樣品,Ag上的Sn/Ni雙層膜的同時測量的案例。
Sn/Ni 雙層膜的膜厚測量案例
■測量條件及標準物質
※ 以上僅為測量案例,並不能保證兩裝置的性能。
■測量條件及標準物質
| 裝置 | FT150h |
|---|---|
| 管電壓 | (DIHP) |
| 光束直徑(※) | 35 μm φ |
| 一次濾波器 | Al1000 |
| 測量時間 | 30秒 |
| 測量方法 | 薄膜FP法 |
| 分析線 | Sn Ka Ni Ka Ag Ka |
| 作為標準物質、將日立高新技術科學制薄膜標準物質 Sn 4.61 μm, Ni 4.89 μm, Ag 8.95 μm 這3個種類重合在Al板上的物質登陸1點。 (※)指擁有30~40 keV能量的一次X射線中包涵了90%強度的直徑 |
|
■測量樣品
使用日立高新技術科學制薄膜標準物質,作為疑似樣品對其進行評價。
| Sn(μm) | Ni(μm) | Ag(μm) | |
|---|---|---|---|
| (1) | 2.01 | 1.90 | 8.95 |
| (2) | 4.61 | 1.90 | 8.95 |
| (3) | 9.43 | 4.89 | 8.95 |
| 通過對Sn及Ni的不同厚度樣品進行反復測量,即便是只有30秒的測量時間,也可得到不到4%的良好重複 性,另外,10 μm厚的Sn下面的Ni的測量結果也非常準確。 利用FT150h,針對從前機種難以測量的微小範圍, 可實現對Sn和Ni的高精度雙層同時測量。 |
|||
■Sn Ka的能譜比較
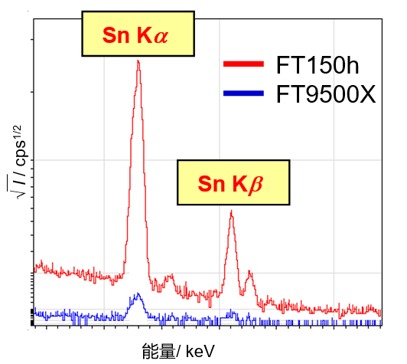
右邊顯示的是FT150h與以往機種FT9500X各自測量大約5 μm的Sn的能譜線。 FT150h利用新型聚光光學系系Vortex檢測器,大幅提升了從前測量困難的Sn Ka線的靈敏度。
■各測量樣品的10次反復測量結果
各測量樣品各進行10次反復測量,評價Sn和Ni的正確性和重複性。
| 表3 測量樣品(1)的反覆測量結果 | |||
|---|---|---|---|
| Sn(μm) | Ni(μm) | Ag(μm) | |
| 平均值 | 2.01 | 1.94 | 8.89 |
| 標準偏差 | 0.051 | 0.037 | 0.046 |
| RSD% | 2.5% | 1.9% | 0.5% |
| 表3 測量樣品(2)的反覆測量結果 | |||
|---|---|---|---|
| Sn(μm) | Ni(μm) | Ag(μm) | |
| 平均值 | 4.63 | 1.93 | 8.82 |
| 標準偏差 | 0.049 | 0.043 | 0.050 |
| RSD% | 1.1% | 2.2% | 0.6% |
| 表3 測量樣品(3)的反覆測量結果 | |||
|---|---|---|---|
| Sn(μm) | Ni(μm) | Ag(μm) | |
| 平均值 | 9.36 | 4.65 | 8.84 |
| 標準偏差 | 0.068 | 0.164 | 0.122 |
| RSD% | 0.7% | 3.5% | 1.4% |
※ 以上僅為測量案例,並不能保證兩裝置的性能。
其他相關訊息
-
14.Oct.2024
X-rite-色差儀 色彩管理中的Lab值是什麽,其中△E又該如何計算?









