зҶұеҲҶжһҗ-DMA зҶұеҲҶжһҗе„Җ(DSCгҖҒDMAгҖҒTMA)еңЁCCL/PCBз”ўжҘӯд№ӢжҮүз”ЁгҖҗжӣҙж–°ж—Ҙжңҹ: 2023/12/19гҖ‘

д»ҖйәјжҳҜCCL/PCB?
йҠ…з®”еҹәжқҝпјҲCopper clad laminateпјҢCCLпјүзӮәиЈҪйҖ еҚ°еҲ·йӣ»и·Ҝжқҝ(Printed circuit boardпјҢPCB)жңҖдё»иҰҒд№ӢеҹәжқҗгҖӮCCL/PCBиЈҪзЁӢдёӯеҫҲйҮҚиҰҒзҡ„йғЁд»ҪпјҢдёҖзӮәжЁ№и„ӮзЎ¬еҢ–зЁӢеәҰпјҢдёҖзӮәзҶұеЈ“еҗҲжўқ件зҡ„жҺ§еҲ¶еҸҠpost-cure жҷӮй–“пјӣеүҚиҖ…еёёз”ЁDSC(зҶұзӨәе·®жҺғзһ„еҚЎйҮҸиЁҲ)дҫҶи©•дј°пјҢеҫҢиҖ…еүҮеҸҜеҲ©з”ЁTMA(зҶұж©ҹжў°еҲҶжһҗе„Җ)гҖҒ DMAпјҲеӢ•ж…Ӣж©ҹжў°еҲҶжһҗе„ҖпјүгҖҒDEAпјҲд»Ӣйӣ»еҲҶжһҗе„ҖпјүгҖҒRheometerпјҲжөҒи®Ҡжё¬и©Ұе„ҖпјүеңЁеҸҚжҮүжә«еәҰйҒҺзЁӢдёӯи§ҖеҜҹе…¶зҶұеЈ“еҗҲйҒҺзЁӢзҡ„й»ҸеәҰи®ҠеҢ–пјҢжңҖеҫҢеёёз”ЁDSCжҲ– DMS(DMA) дҫҶдҪңе“Ғз®ЎеҲҶжһҗе·Ҙе…·гҖӮ
д»ҖйәјжҳҜйҠ…з®”еҹәжқҝ?
- е®№жҳ“зЎ¬еҢ–пјҡеңЁ 5в„ғ~150в„ғзҡ„з’°еўғд№ӢдёӢпјҢз’°ж°§жЁ№и„ӮеҸҜд»Ҙз°Ўе–®дё”еҝ«йҖҹйҖІиЎҢзЎ¬еҢ–еҸҚжҮүпјҢдёҰдё”зЎ¬еҢ–жә«еәҰйҡЁи‘—жүҖйҒёж“ҮдёҚеҗҢзҡ„зЎ¬еҢ–еҠ‘иҖҢж”№и®ҠгҖӮ
- дҪҺй«”з©Қ收縮зҺҮпјҡйҖҷжҳҜз’°ж°§жЁ№и„ӮдёҖеҖӢеҚҒеҲҶйҮҚиҰҒзҡ„зү№жҖ§пјҢеңЁзЎ¬еҢ–йҒҺзЁӢдёӯзӣёијғж–јдёҖиҲ¬зҡ„жЁ№и„ӮпјҢз’°ж°§жЁ№и„Ӯзҡ„й«”з©Қ收縮зҺҮеӨ§зҙ„зӮә3%пјҢйҒ йҒ дҪҺж–јдёҖиҲ¬жЁ№и„Ӯзҡ„10% й«”з©Қ收縮зҺҮгҖӮеӣ жӯӨеӨҡз”Ёж–је°әеҜёиҰҒжұӮијғзӮәзІҫеҜҶз”ЁйҖ”зҡ„ж©ҹжў°гҖҒйӣ»ж©ҹж–№йқўгҖӮ
- иүҜеҘҪзҡ„й»Ҹи‘—жҖ§пјҡзЎ¬еҢ–еҫҢзҡ„жЁ№и„Ӯе…·жңүжҘөжҖ§зҡ„зҫҘеҹәеҸҠйҶҡеҹәпјҢйҖ жҲҗз’°ж°§жЁ№и„Ӯзҡ„й»Ҹи‘—зү№жҖ§гҖӮ
- иүҜеҘҪзҡ„ж©ҹжў°жҖ§иіӘпјҡз’°ж°§жЁ№и„Ӯзӣёијғж–је…¶д»–еҪўејҸзҡ„жЁ№и„ӮжңүијғеҘҪзҡ„ж©ҹжў°зү№жҖ§пјҢйҖҷжҳҜеӣ зӮәз’°ж°§жЁ№и„ӮеңЁзЎ¬еҢ–йҒҺзЁӢдёӯй«”з©Қ收縮зҺҮдҪҺпјҢеӣ жӯӨжңүијғеҘҪзҡ„ж©ҹжў°зү№жҖ§гҖӮ
- иүҜеҘҪзҡ„зө•з·ЈжҖ§иіӘпјҡзЎ¬еҢ–еҫҢзҡ„з’°ж°§жЁ№и„Ӯеӣ зӮәй•·йҸҲдёҠеӯҳжңүйӣҷйҚөзөҗж§Ӣзҡ„жҘөжҖ§е®ҳиғҪеҹәеңҳпјҢеӣ зӮәйӣҷйҚөзҡ„е…ұжҢҜпјҢеҸҜд»Ҙжңүж•Ҳзҡ„еҗёж”¶еӨ–дҫҶйӣ»еӯҗпјҢйҖІдёҖжӯҘйҳ»жӯўйӣ»еӯҗзҡ„еӮійҖҒпјҢеӣ иҖҢеҪўжҲҗиүҜеҘҪзҡ„зө•з·Јзү№жҖ§гҖӮ
- иүҜеҘҪзҡ„жҠ—еҢ–еӯёжҖ§иіӘпјҡзЎ¬еҢ–еҫҢзҡ„жЁ№и„Ӯз”ўзү©еӣ зӮәе…·жңүжҘөжҖ§зҡ„зҫҘеҹәпјҢдёҰдё”з”ұж–јзҫҘеҹәж—Ғзҡ„жҘөжҖ§е®ҳиғҪеҹәеңҳзҡ„еҪұйҹҝпјҢдҪҝеҫ—зҫҘеҹәдёҠзҡ„ж°§еҺҹеӯҗдёҠжүҖеё¶зҡ„йӣ»еӯҗз”ўз”ҹе…ұжҢҜзҡ„жғ…еҪўпјҢйҖ жҲҗжҠ—й…ёй№јзҡ„зү№жҖ§гҖӮ
д»ҖйәјжҳҜеҹәжқҝе·ҘжҘӯ?
- A stageпјҡжҢҮй җжөёж–ҷпјҲPrepregпјүиЈҪйҖ йҒҺзЁӢдёӯпјҢе…¶иЈңеј·жқҗж–ҷзҡ„зҺ»зә–еёғжҲ–жЈүзҙҷпјҢеңЁйҖҡйҒҺиҶ ж°ҙж§ҪйҖІиЎҢеҗ«жөёе·ҘзЁӢжҷӮпјҢи©ІжЁ№и„Ӯд№ӢиҶ ж°ҙпјҲVarnishпјҢд№ҹиӯҜзӮәжё…жјҶж°ҙжҲ–еҮЎз«Ӣж°ҙпјҢж¶Іж…Ӣеә•жқҗпјҢдёҖиҲ¬зӮәз’°ж°§жЁ№и„ӮпјүпјҢе°ҡиҷ•ж–је–®й«”дё”иў«жә¶еҠ‘зЁҖйҮӢзҡ„зӢҖж…ӢпјҢзЁұзӮәA-StageгҖӮ
- B stageпјҡгҖҢPrepregгҖҚжҳҜгҖҢpre-impregnatedгҖҚзҡ„зё®еҜ«пјҢж„ҸжҖқзӮәй җеӮҷжөёжј¬пјҢжҢҮзҺ»з’ғзә–з¶ӯжҲ–е…¶е®ғзә–з¶ӯжөёжј¬еә•жқҗпјҲж¶Іж…Ӣз’°ж°§жЁ№и„Ӯпјү經еҠ зҶұжҒҶжә«йҒҺзЁӢпјҢдҪҝйғЁд»ҪиҒҡеҗҲз”ўз”ҹе…·й»Ҹи‘—жҖ§зҡ„еҚҠд№ҫзӢҖж…ӢиҖҢзЁұд№ӢгҖӮжҘӯз•ҢдёҖиҲ¬зЁұCarbon fiber prepregзӮәзўізә–з¶ӯй җжөёеёғпјҢе…¶еә•жқҗпјҲз’°ж°§жЁ№и„ӮпјүжӯӨжҷӮжҳҜB-stageпјҢеҚіжҳҜе°ҮзҶұеӣәеһӢжЁ№и„ӮиҒҡеҗҲиҮій җеӮҷзЎ¬еҢ–йҡҺж®ө(еҚіжЁ№и„Ӯд№ӢB-stage)гҖӮ
- C stageпјҡйҠ…з®”иҲҮиҶ зүҮеңЁй«ҳжә«жўқ件дёӢ經йҒҺзҶұеЈ“еҗҲпјҲеӨҡеұӨжҲ–жҳҜе–®еұӨпјүзЎ¬еҢ–жҲҗзҡ„жңҖзөӮзӢҖж…ӢпјҢиЈҪжҲҗйҠ…з®”еҹәжқҝгҖӮ
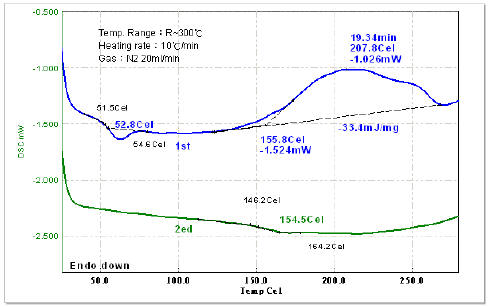

(ең–дёҖ) A stageйҮҸжё¬жЁ№и„Ӯд№ӢеҸҚжҮүжҖ§пјҢжүҫеҮәжңҖйҒ©еҠ е·Ҙжўқ件гҖӮ

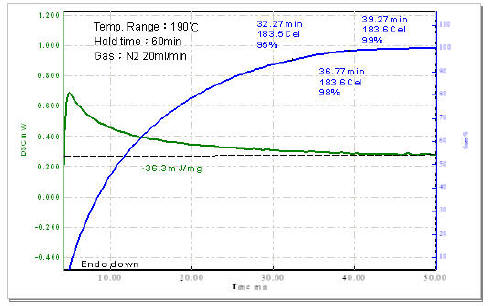

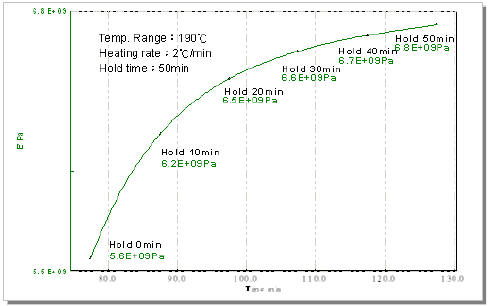
(ең–еӣӣ) DMA post-cureжҒҶжә«йҒҺзЁӢжё¬йҮҸзөҗжһңгҖӮ
з”ұең–дә”еҸҜзңӢеҮәжқҗж–ҷC stageдёӢзҡ„жқҗж–ҷзү№жҖ§

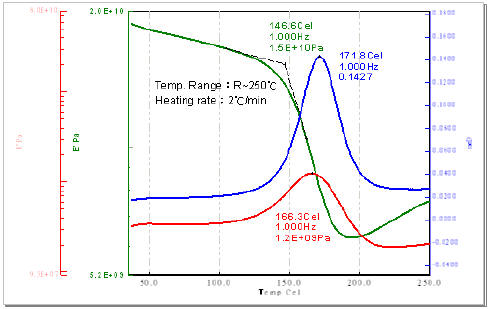
(ең–дә”) DMA第дәҢж¬ЎеҚҮжә«жё¬йҮҸзөҗжһңгҖӮ
еңЁCCLеҸҠPCBиЈҪзЁӢдёӯж¬Іеҫ—еҲ°жңҖдҪізҡ„еҠ е·Ҙжә«еәҰгҖҒжҷӮй–“гҖҒзөҗжһңеҸҠжқҗж–ҷзү№жҖ§пјҢи—үз”ұDSC(зҶұзӨәе·®жҺғзһ„еҚЎйҮҸиЁҲ)гҖҒTMA(зҶұж©ҹжў°еҲҶжһҗе„Җ)гҖҒDMAпјҲеӢ•ж…Ӣж©ҹжў°еҲҶжһҗе„ҖпјүеқҮеҸҜжё¬еҫ—пјҢжҳҜеңЁCCLжҲ–PCB з”ўжҘӯз•ҢдёӯеҒҡзӮәз ”зҷјеҸҠе“Ғз®ЎдёҚеҸҜжҲ–зјәзҡ„йҮҚиҰҒиЁӯеӮҷгҖӮ
иӢҘжңүд»»дҪ•жҠҖиЎ“е•ҸйЎҢжҲ–з”ўе“ҒйңҖжұӮпјҢжӯЎиҝҺиҲҮжҲ‘еҖ‘иҒҜзөЎпјҒ









