- 技術應用 -
15.Aug.2022
質譜儀-Mass 熱脫附質譜TDS應用於矽晶圓逸散氣體分析

了解矽晶圓逸散氣體分析應用
半導體晶圓製程中的汙染物,包含自然生成氧化層,晶圓表面暴露於空氣或水中的溶氧,而氧將晶圓表面的矽氫鍵(Si-H)氧化成為羥基(Si-OH)。氫氟酸(HF)通常在矽晶片加工中用作表面處理,以去除表面氧化物,並提供在短時間內抵抗污染的氫端(Hydrogen termination, Si-H)表面鈍化。為了研究HF處理後,氫端(Hydrogen termination)在矽晶片表面隨時間是如何變化,以紅外線加熱式熱脫附質譜儀TDS在矽晶片熱脫附氫端。首先製備了氫端矽晶片,在樣品製備後2、7、14和28天,將晶片進行熱脫附實驗。加熱速率為60℃/秒。比較在不同溫度下氫氣脫附的狀況。
分析結果如下圖,矽晶片表面的氫隨著放置時間越長,表面的氫逐漸減少。它減少到什麼程度,可以進一步的跟踪實驗。表面的氫減少的原因,推測可能是產生氧化反應,在表面產生羥基。
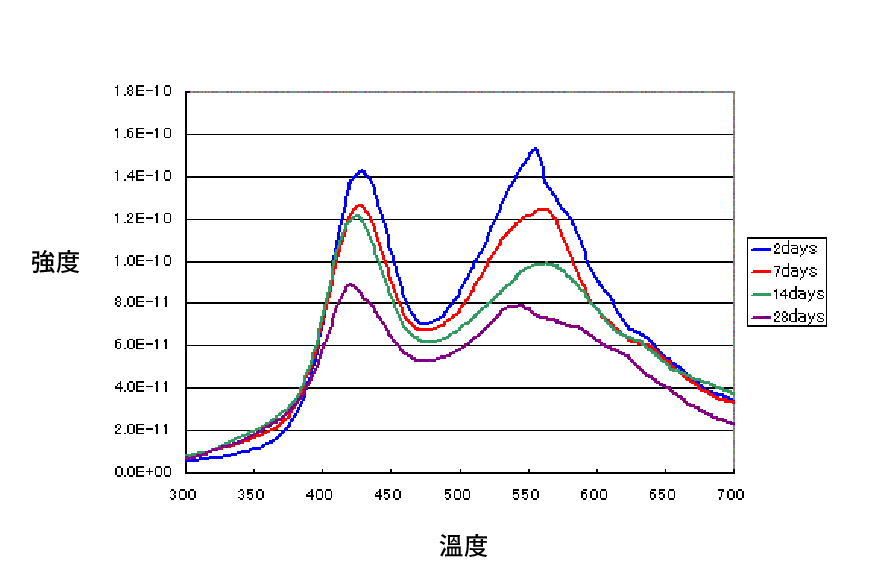
▲樣品在放置2、7、14、28天後,以TDS分析氫脫附
同樣的分析條件下,同時監測水(m/z 18)的訊號,下圖顯示了表面上的氫和羥基結合並釋放水。正如預期,水的含量會隨著放置的時間越長而增加。

▲樣品在放置2、7、14、28天後,以TDS分析H2O脫附
紅外線加熱式熱脫附質譜儀 TDS 1200 II可在超高真空度下,分析樣品在紅外線下加熱,因此,不會有空氣或背景訊號的干擾,可以確實分析來自樣品的脫附出的氣體進行定性、定量分析,包含H2, N2, H2O, CH4, CO2, Ar, Xe, He, O2, C2H6, CO及Kr等氣體。可應用在製程中熱處理時產生的未知揮發物分析,是分析材料逸散氣體十分重要的工具。
其他相關訊息
-
01.Apr.2024
質譜儀-Mass 不挑選樣品型態之DART-TOFMS應用於濫用藥物即時分析
-
25.Mar.2024
雷射剝離 綠光雷射剝離加工機應用在PI(聚醯亞胺)膜加工的3大優勢
-
11.Mar.2024
熱分析-DSC DSC用於環氧樹脂的固化率測量與工業應用